[ad_1]
AMD اطلاعات جدیدی را در رابطه با تکنولوژی چیپلت سهبعدی جدید خود منتشر کرده است. قرار است این تکنولوژی در نسل بعدی چیپهای Zen 3 همراه با فناوری 3D V-Cach به کار گرفته شود.
چیپلت سه بعدی AMD با معماریهای مختلف برای کاربردهای متفاوت
شرکت AMD در رابطه با طرحهای چیپلت سهبعدی موجود خود و آنچه که در آینده برای تراشههای چندلایه در Hot Chips 33 وجود دارد اطلاعاتی منتشر کرده است. در حال حاضر 14 مدل معماری برای چیپلتهای در حال توسعه، برای محصولات مختلف وجود دارد، که برخی از آنها قبلا منتشر شده است و بعضی به زودی منتشر میشود. AMD گفته است که انتخاب مدل بستهبندی و معماری چیپلت به عملکرد، قدرت، سطح و قیمت نهایی محصول مورد نظر بستگی دارد. به صورت خلاصه به این فرایند PPAC میگویند. (Performance,Power,Area,Cost)
تراکم بالاتر در مساحت کمتر
بر اساس آنچه شرکت AMD در گذشته اعلام کرده، قرار است در سال 2021 معماری چیپلت سهبعدی خود را معرفی کند. در گذشته ما شاهد بستهبندی 2 بعدی و 2.5 بعدی در محصولات مخصوص سرور بودهایم. اما حالا قرار است که بالاخره از فناوری 3D V-Cache هم در محصولات جدید AMD استفاده شود. اولین محصولی که قرار است از این فناوری استفاده کند، هسته Zen 3 AMD خواهد بود که دارای کش SRAM بر روی Zen 3 CCD است. استفاده ار فناوری چیپلت سهبعدی تراکم اتصالات را بسیار افزایش میدهد، در حالی که سطح آن و میزان انرژی مصرفی در پایینتر سطح ممکن باقی میماند.

شرکت AMD نحوه اتصال 3D V-Chiplet به بالای ZEN 3 CCD را شرح داده است. این کار با استفاده از Micro Bump سهبعدی و چندین اتصال TSV انجام میشود. برای این اتصال از یک پیوند Dielectric-Dielectric همراه با اتصال مستقیم CU-CU استفاده شده است. AMD برای رسیدن به این فناوری همکاری گستردهای را با شرکت TSMC داشته است. با استفاده از این فناوری میتوان دو قطعه سیلیکون جداگانه (Chiplet) را به هم متصل کرد.
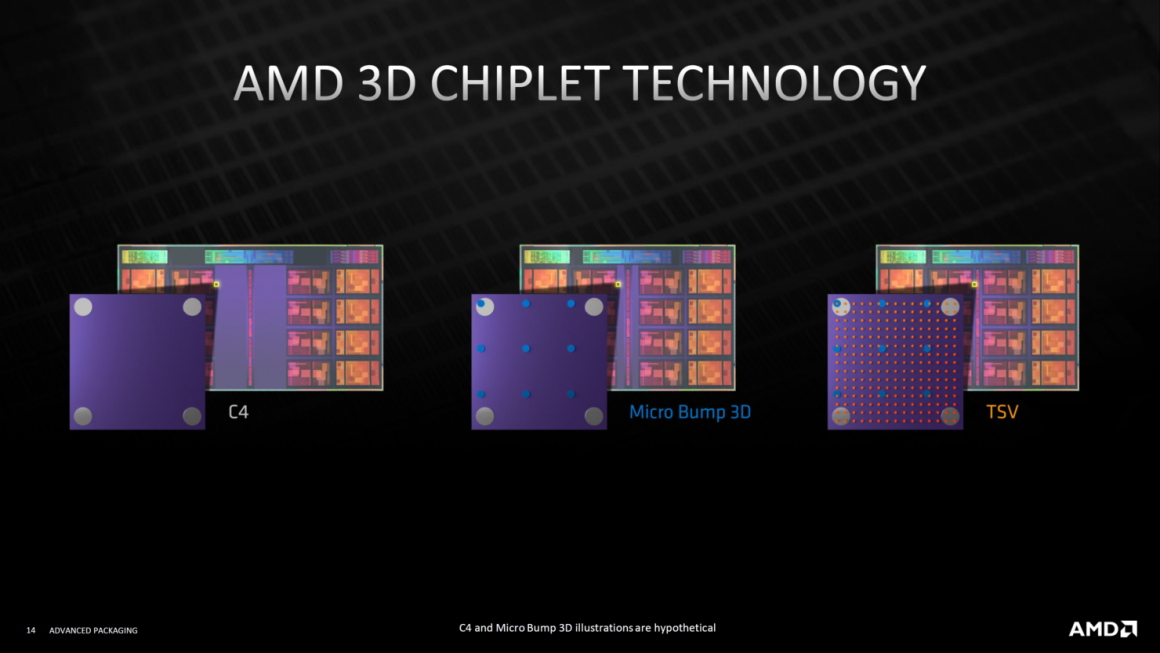
کوچکتر از فناوری اینتل
بر طبق گفته AMD، اتصالات ترکیبی دارای طول 9u و back-end بسیار به TSV شبیه هستند، که کمی از Foveros اینتل با طول 10u کوچکتر است. راندمان انرژی آن در مقایسه با Micron Bumb 3DM از 3 برابر است. همچنین چگالی اتصال آن 15 برابر Micron Bump 3D درجهبندی شده است. همچنین به لطف کاهش تعداد خازن در TSV قدرت سیگنال و القاءمغناطیسی بهتری را ارئه میدهد.

AMD تاکید دارد که این DRAM پردازنده، تازه سادهترین چیزیست که میتواند با استفاده از چیپلت سهبعدی به دست بیاورد. AMD قصد دارد در آینده از این چینش سهبعدی برای چیدن هسته پردازندهها استفاده کند و بتواند هستهها را در بالای یکدیگر بچیند. در نتیجه میتوان بلوکهای ماکرو رو به صورت سهبعدی بر روی سایر بلوکها قرار داد.
مطالب مرتبط:
امتیاز: 5.0 از 5 (1 رای)
کمی صبر کنید…
[ad_2]
منبع خبر














